Le aziende che si occupano della progettazione e della produzione di microprocessori stanno testando nuove tecnologie per la realizzazione di chip che vanno ben oltre i sistemi tradizionali. Intel, ad esempio, ha svelato tecnologie di packaging piuttosto avanzate come Foveros, che permette di impilare più chip su un singolo chip, ed EMIB (Embedded Multi-die Interconnect Bridge), interconnessione che consente di veicolare i segnali elettrici attraverso lo stesso substrato.
Adesso Intel ha annunciato Co-EMIB, un processo molto più complesso che mescola Fovero e EMIB insieme con l’utilizzo di una nuova interconnessione chiamata ODI (Omni-Directional Interconnect).
In un video esplicativo, i tecnici di Intel spiegano il funzionamento di Co-EMIB: si vede come vengano impiegati Foveros (ne abbiamo parlato a suo tempo nell’articolo Intel parla delle nuove GPU integrate Gen.11, delle sue schede grafiche dedicate e di Foveros), per impilare i chip direttamente sul wafer, con la creazione dei percorsi attraverso il silicio e le zone di contatto per creare un incapsulamento unitario di diversi chip (EMIB).
Grazie a Co-EMIB, Intel potrà assicurare interconnessioni ad alta densità, elevata ampiezza di banda e bassa latenza contenendo al massimo i consumi energetici.
Non si è ancora parlato di “numeri” ma è probabile che Intel possa condividere maggiori informazioni durante il mese di agosto, momento clou dell’anno per i produttori di semiconduttori.
L’interconnessione omnidirezionale di Intel consente la comunicazione tra i vari chiplet: si potranno in questo modo realizzare prodotti estremamente versatili e flessibili.
ODI, combinata con Co-EMIB, faciliterà il lavoro ai progettisti che intendono combinare diverse tecnologie e unità funzionali in un unico chiplet di piccole dimensioni (si pensi alla possibilità di unire diverse tipologie di die come CPU, GPU e unità per l’intelligenza artificiale creando sistemi integrati personalizzati e a elevate prestazioni).
ODI permette anche di ottimizzare la struttura del die permettendo l’impiego di un maggior numero di transistor attivi e aiutando a ridurre le dimensioni.
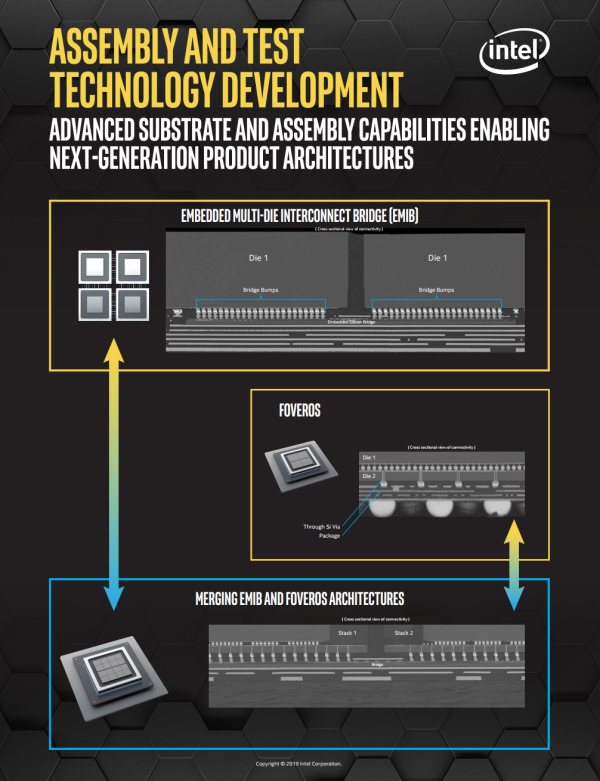
/https://www.ilsoftware.it/app/uploads/2023/05/img_19574.jpg)
/https://www.ilsoftware.it/app/uploads/2026/04/chip-intel-serpent-lake-nvidia-rtx.jpg)
/https://www.ilsoftware.it/app/uploads/2026/04/collaborazione-intel-arm.jpg)
/https://www.ilsoftware.it/app/uploads/2026/03/intel-core-ultra-series-3-processori-business.jpg)
/https://www.ilsoftware.it/app/uploads/2026/03/chip-arm-agi-cpu.jpg)